硅像素传感器文献调研(七)

多重场限环结构优化设计的新方法
摘要
在本文中,一个基于计算机的分析进行研究的布局解决方案,旨在提高硅微带探测器的击穿电压。对于最佳性能,它是至关重要的,以实现最大的击穿电压硅探测器工作在非常高的偏置,由于下一代实验,如大型强子对撞机的极端恶劣的辐射环境。硅微带探测器的性能可以通过在有源探测器区域周围实现浮动场限制环来改善。已经进行了模拟研究,以评估作为保护环间距(GS)的函数的击穿电压的分布。本工作的目的是找到一个标准,以优化GS的多个环结构,包括各种物理和几何参数作为设计优化的援助。利用该准则,得到了多环结构中保护环的最佳间距。该判据具有很强的鲁棒性,对保护环数目、结深和辐射损伤不敏感。七环设计的仿真结果与实验测量结果吻合良好。
1.引言
硅探测器在高能实验中的应用再怎么强调也不过分。计划用于大型强子对撞机(LHC)的硅探测器系统比迄今为止任何以前的实验都要大。由于LHC环境中的高亮度和非常高的辐射水平,Si探测器的制造是一项具有挑战性的任务。为了在整个LHC寿命期间安全操作,检测器需要维持非常高的电压操作,远远超过完全耗尽重度辐照的Si微带检测器所需的偏置电压。因此,在Si探测器的发展的主要努力集中在设计,避免在工作偏压的p-n结击穿。
“结曲率效应”严重限制了平面结的击穿电压[1,2]。为了克服这种限制,已经开发了几种平面结终端技术[3-17]。在这些技术中,场限环(FLR)[3-15]和金属悬置[16,17]是技术上简单并且适用于垂直(电流流动)装置。
为了优化检测器设计,识别雪崩可能优先发展的区域并将这种现象的阈值与几何和物理器件特性相关联是至关重要的。CAD工具的采用允许人们评估器件内的实际场分布,并且使得能够识别关键区域。因此,设计优化可以通过计算机模拟技术以相对快速和廉价的方式进行。作为设计辅助,使用TMAMEDICI进行二维模拟[21]。在我们早期的工作[3]和[17]中,模拟器根据具有保护环和金属悬突的平面结的实验数据进行了严格校准。在这项工作中,模拟的可靠性进行了检查,通过比较模拟结果与实验测量的Si-微带探测器与7个保护环制造的巴拉特电子有限公司,印度。这些原型探测器的制造目前正在印度进行,将用于CERN LHC CMS的预簇射探测器。

图1?仿真中采用了简化的保护环结构。
本文研究了FLR对硅微带探测器击穿性能的影响,提出了一种优化保护环间距的准则。这种方法可以在FLR覆盖的广阔区域上重新分布结周围的电势,从而减少平行于表面的电场分量。所提出的解决方案适用于围绕检测器的敏感部分的任何数量的保护环。我们还研究了GS与结深的变化,发现所提出的标准是适用于实现最高的击穿电压。考虑到这些探测器在高辐射环境中的应用,优化标准必须考虑辐射效应。该标准被发现是独立的氧化物电荷诱导由于电离辐射,也不敏感的衬底电阻率的变化,由于体损伤的p型。因此,达到的标准是简单的,但有吸引力的,因为它是独立的几个参数,如保护环的数量,结深和辐射损伤。
2.器件结构
图1显示了配备浮动FLR的p+-n二极管的器件结构。晶片的取向为111,电阻率约为4 k Ωcm,这对应于约1 × 1012 cm-3的均匀衬底掺杂浓度(NB)。所有的p+注入都是通过假设高斯分布近似的,表面的峰值浓度为5×1019 cm?3。模拟中使用的参数是根据工艺过程的特点来假定的。假设p区曲率处的横向扩散深度等于垂直结深度(Xj)的0.8倍。GS是在扩散p区之间的表面处的均匀n区的宽度。
3.仿真技术
上述结构用于使用二维器件模拟程序TMA-MEDICI版本2000.4研究击穿分析。TMA-MEDICI求解了泊松方程、连续性方程、能量平衡方程以及空穴和电子的晶格热方程。所有上述方程描述了在外场影响下半导体中载流子的静态和动态行为。在模拟中,耗尽区通过正向偏置背欧姆接触获得。二极管的前侧接地,保护环悬空。
使用的物理模型是肖克利-里德-霍尔和俄歇复合,浓度和场依赖迁移率模型。为了避免电离积分中的任何模糊性,使用碰撞电离模型。模型中使用的参数是手册中规定的默认参数[21]。当前的边界条件施加在浮动保护环和均匀(反射)诺依曼边界条件的非接触的结构的外边缘。背面的欧姆接触和正面的二极管由Dirichlet边界条件实现。为了模拟电离辐射的影响,在Si-SiO2界面处实施氧化物电荷。衬底的有效掺杂浓度被改变为p型,以模拟由于辐射造成的体损伤的效果。为了准确地预测结击穿电压(VBD),结曲率的影响,导致更高的电场在器件的角落被列入计划。可以绘制电势等值线、碰撞电离产生率、电场线和电流线。因此,可以准确地识别击穿发生的位置。
4.结果与讨论
在文献[3-8]中详细研究了探测器结侧FLR结构操作的物理学。使用一个或多个FLR,可以减小结曲率对击穿特性的影响,并且当所施加的电压在主结和保护环之间分配时,表面电场显著降低。相邻环之间的电位降取决于它们之间的间距。当主结与保护环之间的间距过小或过大时,FLR的影响变得不明显。因此,为了最大化VBD,明智地选择FLR的最佳放置是至关重要的。
下面给出的结果是为了研究用于优化结合各种物理和几何参数的多保护环结构的标准而进行的模拟的集合。
为了优化第一个GS,间距在15和55 μm之间变化,步长约为10 μm。图2给出了阳极-FLR距离与阳极结和FLR结处的峰值表面电场(EFS)之间的关系。每个表面场随FLR位置而变化。随着第一GS(IGS)的增加,阳极结处的EFS变大,而FLR处的EFS变小。当IGS = 35 μm时,阳极结和FLR处的EFS值几乎相同,我们期望在此IGS值下获得最大击穿电压。图3显示了不同环间距下器件的I-V特性。作为参考,还模拟了没有保护环的二极管。显然,击穿电压从1010 V(没有保护环的结构)转变到1420 V(具有单个最佳放置的保护环的结构),对应于大约40%的增加。这里,最大击穿电压的条件用作保护环的最佳间距的标准。从上面的讨论中可以清楚地看出,阳极和保护环表面电场的等值条件完全可以作为第一保护环优化的判据。
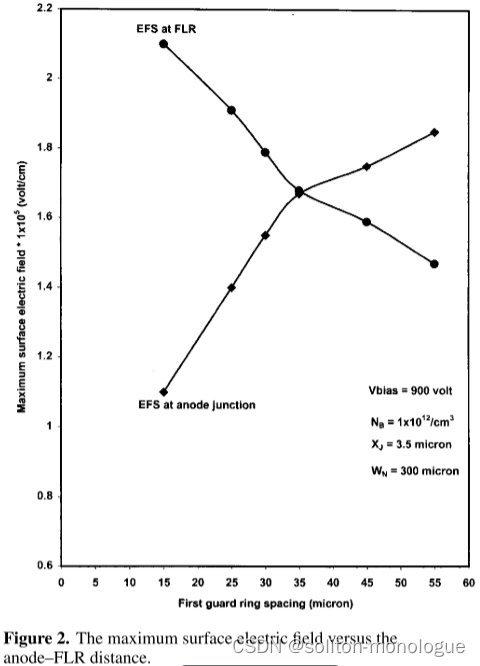
图2?最大表面电场与阳极-FLR距离的关系。

图3?具有单个保护环的p+n二极管的反向I-V特性。“无FLR”是指没有保护环的结构的I-V特性。
图4示出了针对不同结深(XJ)的作为GS的函数的击穿电压的曲线图。可以看出,VBD随着XJ的增加而增加。这是因为结曲率处的每单位面积的电通量随着XJ增大而减小,因此VBD增大。最佳间距也随着XJ的增加而增加。但是,对于所有结深,表面的等值条件电场导致最大击穿电压,证明了我们提出的标准。

图4?IGS对不同结深击穿电压的影响。
我们还担心辐射损伤对保护环设计的不利影响。辐照器件的器件行为可以通过参考两种损伤类别来研究:表面损伤和体损伤。来自中性强子的非电离辐射引起体损伤,导致有效掺杂剂浓度的变化,从而导致所谓的类型反转。研究发现,n型探测器随着注量的增加,其n型逐渐减少,直到在1013个中子cm?2时,它们才转变为有效的p型。除了反转之外,该器件在进一步的辐照下继续变得更加p型,显然没有限制。电离辐射,除了体损伤,还引起表面损伤,这是由于在Si-SiO2界面处的空穴捕获而发生的。因此,为了分析设计准则,我们研究了表面损伤和体损伤对探测器击穿性能的影响。表面损伤的影响可以通过增加Si-SiO2界面处的氧化物电荷密度(Qf)来考虑,至少增加到一阶近似。对于在111晶向的Si上生长的非辐射高质量SiO2,其密度约为1 × 1011 cm?2。在电离辐射下,它迅速上升,并在约1 × 1012 cm?2处饱和[18]。这些表面电荷在硅微带探测器表面形成一个积累层,对硅微带探测器的击穿电压有很大的影响。耗尽区在表面的收缩导致电场的增加,从而导致器件的过早击穿。针对不同的电荷密度值执行仿真。图5显示了VBD作为IGS的函数,Qf作为运行参数。对于所有的氧化物电荷密度的最大击穿电压时,实现了等值的表面电场的标准得到满足。这表明该准则对辐射诱导电荷具有鲁棒性。VBD对表面电荷敏感,并且随着Qf的增加而减小。在最佳间距下,随着Qf从0增加到5 × 1011 cm?2,它从1420 V降低到415 V。还可以看出,单个浮置p+防护装置的最佳间距为35 μm。这表明,优化的环间距保持不变,而不管表面电荷。
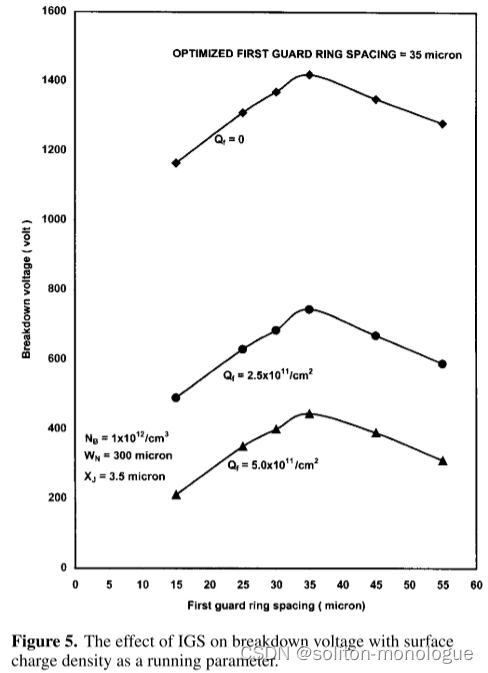
图5?以表面电荷密度为运行参数,研究了IGS对击穿电压的影响。
通过改变有效衬底掺杂浓度(Neff)作为注量的函数来模拟体损伤。模拟针对两个Neff值进行,当衬底变为对应于5年(Neff = 1.25 × 1012)和10年(Neff = 3.63 × 1012)的p型时,考虑到Si探测器在整个LHC寿命内的操作场景[19]。Neff的值使用以下关系式计算:

其中W是探测器厚度,q是电子电荷,εSi是硅介电常数。
完全耗尽电压(VFD)的值取自[19]。表1示出了在初始浓度Neff = 1.0 × 1012 cm?3的类型反转之前(n型)和在两个Neff值的类型反转之后(p型)的击穿电压作为IGS的函数的模拟结果。可以看出,对于两种p型浓度,最大VBD当满足主结和保护环处的最大表面电场值相等的准则且最佳间距保持不变时,即,IGS = 35 μm,与初始设计相同。即使衬底浓度增加,VBD也在类型反转后增加。Bloch等人最近已经报道了这一结果[20]。我们模拟了两种p型浓度下Qf = 5×1011 cm?2的结构,假设在电离下辐射表面电荷迅速上升,甚至在类型反转发生之前饱和。同样在这种情况下,对于IGS = 35 μm的相同结构,获得的最大VBD满足所提出的标准,表明本标准与体损伤和表面损伤无关,并且可以很好地用于下一代实验中使用的探测器。
表1?具有单个保护环的Si探测器在类型反转前后的击穿电压

使用两种不同的方法优化第二保护环:(a)保持第一保护环相对于阳极结以最佳间距固定,并改变第二保护环相对于第一保护环的间距[9],以及(B)改变第一保护环和阳极结之间的间距,并保持第二保护环和第一保护环之间的间距恒定; 10]。在本文中,我们比较了上述两种方法的模拟结果。表2列出了具有两个保护环的器件的击穿电压。在第一组中,第一和第二环之间的间距在15至40 μm之间变化,主结和第一保护环之间的间距保持在35 μm。第二环的最佳环间距为25 μm,击穿电压为1560 V。在SetII中,我们将第一环和主结之间的间距在15和45 μm之间变化,使第二保护环相对于第一环的间距固定在35 μm。在这种情况下,当第一和第二保护环的最佳环间距分别为25和35μ m时,获得的最大击穿电压为1640 V。然而,上述结果都不满足阳极结和保护环的EFS值相等的标准。因此,我们继续进行模拟,以满足上述标准,当IGS = 27 μm和IIGS = 40 μm时,我们获得了VBD = 1740 V的最大值(设置III)。因此,在两个保护环处于最佳间距的情况下,VBD从1420 V(具有单个优化保护环的结构)偏移到1740 V,对应于大约30%的增加。
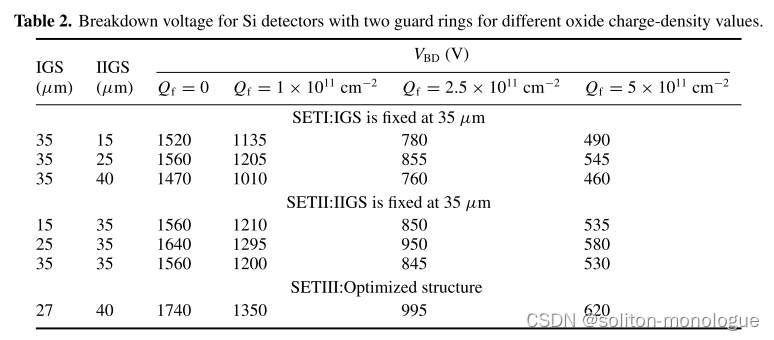
表2?具有两个保护环的硅探测器在不同氧化物电荷密度值下的击穿电压。

从表2可以看出,对于所有模拟的Qf值,当IGS=27微米,IIGS=40微米时,达到最大VBD。因此,优化的间距被认为与氧化物电荷无关。然而,当QF从0增加到5.0×1011 cm?2时,对于优化的结构,VBD值从1740V下降到620V。
我们已经研究了一些可能的结构与七个保护环,以实现最大的VBD,并验证我们提出的多环结构的标准。在所有六种结构中,相邻保护环之间的间距是变化的。六种布局的横截面如图6所示,不同布局的击穿电压如表3所示。

图6?该结构的横截面有七个护环,用于六种不同的布局。数字不是为了规模。距离以微米表示。
表3?具有六种布局的七保护环结构在不同氧化物电荷密度值下的击穿电压。

对于L1,VBD约为1420 V,与其他布局中实现的VBD相比,VBD要小得多。实际上,L1的VBD小于通过具有两个保护环的优化结构实现的VBD(1740 V)。对于L1,已经看到主结处的电场不减小这基本上是由于第一保护环相对于主结的相对较大的间距。这表明,增加更多的保护环仅仅降低了第一保护环处的电场,而对阳极结的电场没有影响。通过减小保护环之间的间距,环之间的电势差减小,在给定偏置电压下更多的表面被耗尽,并且电势降因此沿着表面分布在更大的距离沿着上,导致击穿电压的增加。从图6和表3中可以明显看出这一点。
很明显,VBD与设计高度相关,L6设计实现了最大VBD = 2530 V其中最大表面电场在阳极结和所有七个保护环处具有几乎相同的值(图7)。这验证了所提出的多环结构优化准则。

图7?对于L6布局,Vbias = 900 V时的表面电场图。
表4?L6版图七保护环结构类型反转前后的击穿电压

从表2可以看出,随着Qf增加,对于特定布局,VBD减小。对于L1,当Qf从0增加到5 × 1011 cm?2时,VBD的值减少了1.81%。但是对于L2,相应的减少是70%。类似地,当我们从L3到L6时,VBD值的百分比下降继续下降,并且对于L6,它降低到1.51%。因此,随着结构优化的改进,VBD的减少是最低的,从而确立了所提出的结构的功效。
我们还模拟了L6设计,设想了Qf = 0和5×1011 cm?2时由于辐射损伤引起的体反转。结果列于表4中。在这里,我们再次观察到,与类型反转之前获得的击穿电压相比,击穿电压的相应值已经增加,如在单保护环结构的情况下发生的那样。这表明,在类型反转后,随着p型有效浓度的增加,所提出的设计的VBD增加。
5 结论
它已被证明,多环结构可以提高硅探测器的击穿极限,提供的保护环仔细优化。我们的模拟结果已经建立,在阳极和环的表面电场值相等的建议条件完全服务于多个环的优化标准。已经发现,通过遵循表面电场值相等的上述准则,对于不同的结深度获得最高击穿电压。该标准的另一个吸引人的特征是,即使在器件由于辐射损伤而发生变化时,它也是有效的。一个有趣的结果被发现,即,类型反转后的击穿电压增加。Bloch等人在实验中观察到了这一结果[20]。七保护环结构的模拟显示出良好的协议与制造的设备上的测量。
本文来自互联网用户投稿,该文观点仅代表作者本人,不代表本站立场。本站仅提供信息存储空间服务,不拥有所有权,不承担相关法律责任。 如若内容造成侵权/违法违规/事实不符,请联系我的编程经验分享网邮箱:chenni525@qq.com进行投诉反馈,一经查实,立即删除!
- Python教程
- 深入理解 MySQL 中的 HAVING 关键字和聚合函数
- Qt之QChar编码(1)
- MyBatis入门基础篇
- 用Python脚本实现FFmpeg批量转换
- java并发编程十四 Fork/Join
- 线性代数——(期末突击)行列式(上)-行列式计算、行列式的性质
- FilterQuery过滤查询
- SpringBoot ElasticSearch 聚合统计
- 《十堂课学习 Flink》第五章:Table API 以及 Flink SQL 入门
- 13.bash shell中的if-then语句
- 【零基础数据采集】采集京东平台商品信息
- Docker单点部署Seata(2.0.0) + Nacos(v2.3.0) + Mysql(5.7)
- 「优选算法刷题」:三数之和
- 【C语言】动态内存函数介绍