芯片工程系列(1)封装基础知识、分来、步骤与方法.md
英文缩写
- 环氧树脂模塑料(Epoxy Molding Compound,EMC)
- 引线框架封装(Leadframe),
- 基板封装(Substrate),Substrate 基板
- 晶圆片级芯片规模封装(Wafer Level Chip Scale Packaging)
- 重新分配层(Re-Distribution Layer)
- 硅穿孔(Through Silicon Via,TSV,也称做硅通孔)
- 锡球(Solder Balls)
- 切割胶带(Dicing Tape)
- 印刷电路板(Printed Circuit Board,PCB)
- 芯片键合(Die Bonding)
- 芯片贴装(Die Attach)
- 引线键合(Wire Bonding)
- 倒装芯片键合(Flip Chip Bonding)
- 凸块(Bump)
封装的作用
半导体封装的四个主要作用:机械保护、电气连接、机械连接和散热
- 机械保护:硅像玻璃一样,非常易碎,容易受到物理性和化学性损坏。半导体封装的主要作用是通过将芯片和器件密封在环氧树脂模塑料(EMC-Epoxy Molding Compound)等封装材料中,保护它们免受物理性和化学性损坏。
- 电气连接:封装通过芯片和系统之间的电气连接来为芯片供电,同时为芯片提供信号的输入和输出通路。
- 机械连接:需将芯片可靠地连接至系统,以确保使用时芯片和系统之间连接良好。
- 散热:如果半导体封装无法有效散热,则芯片可能会过热,导致内部晶体管升温过快而无法工作。
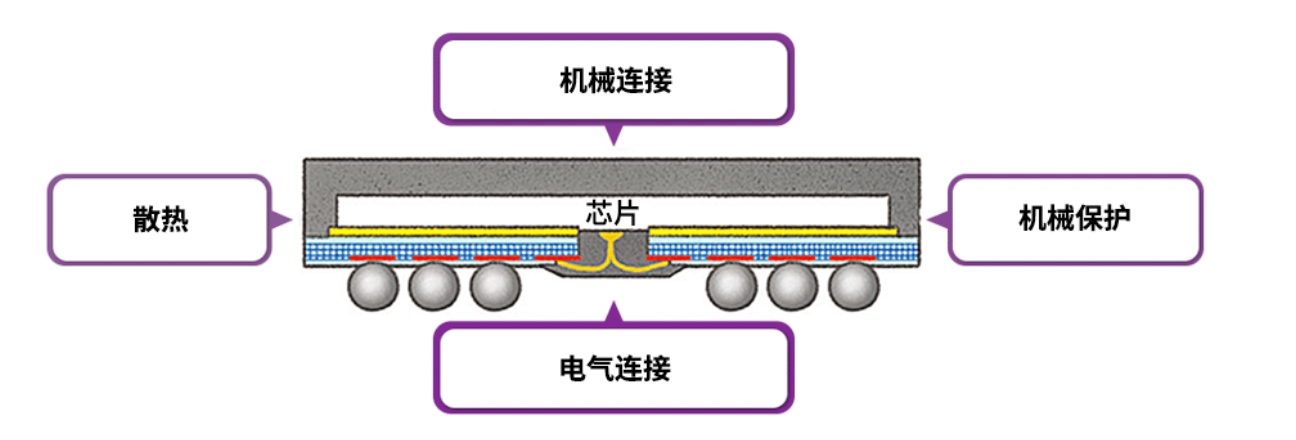
封装分类
分类标准:材料
根据封装材料的不同,传统封装方法可进一步细分为陶瓷封装和塑料封装。
分类标准:媒介
塑料封装中,根据封装媒介的不同,又可进一步分为引线框架封装(Leadframe)或基板封装(Substrate)。
分类标准:封装方法
根据晶圆级封装方法可进一步细分为四种不同类型:
- 晶圆级芯片封装(WLCSP),可直接在晶圆顶部形成导线和锡球(Solder Balls),无需基板;
- 重新分配层(RDL),使用晶圆级工艺重新排列芯片上的焊盘位置,焊盘与外部采取电气连接方式;
- 倒片(Flip Chip)封装,在晶圆上形成焊接凸点2进而完成封装工艺;
- 硅通孔(TSV)封装,通过硅通孔技术,在堆叠芯片内部实现内部连接。
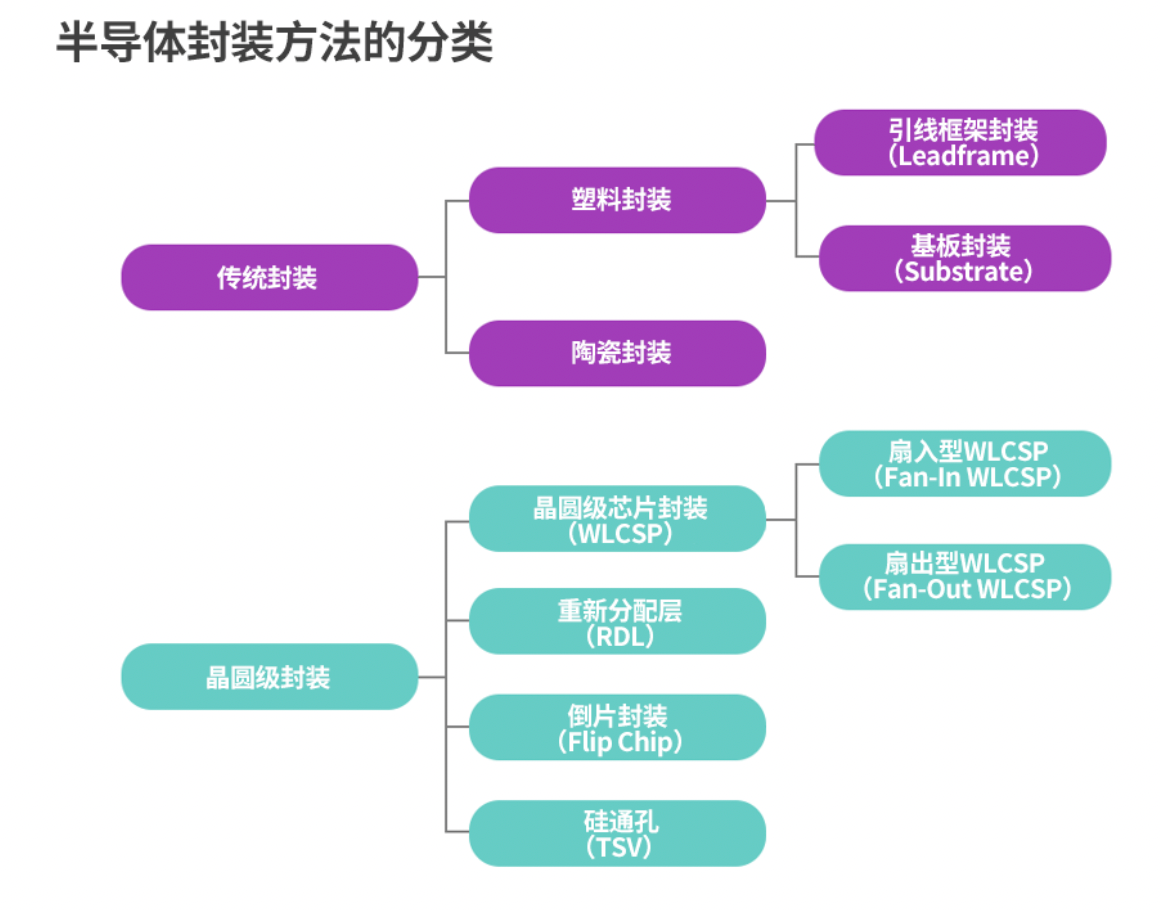
封装工艺步骤
封装工艺包含背面研磨(Back Grinding)、划片(Dicing)、芯片键合(Die Bonding)、引线键合(Wire Bonding)及成型(Molding)等步骤。
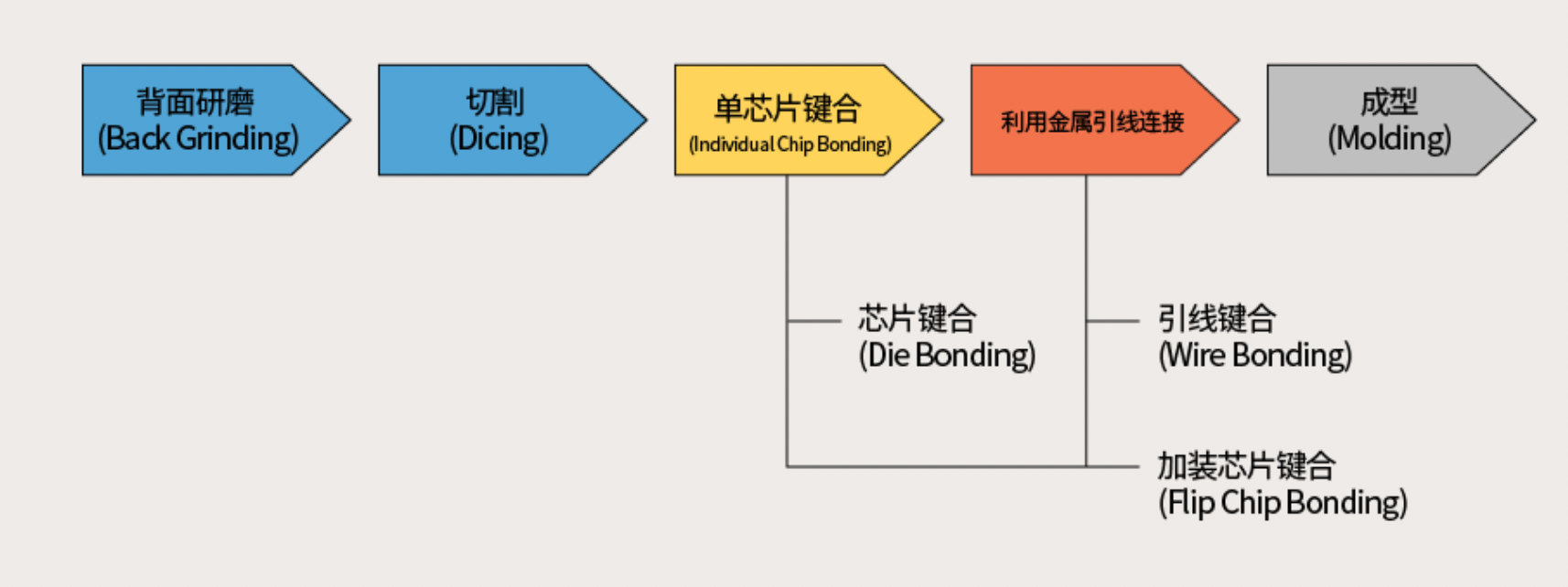
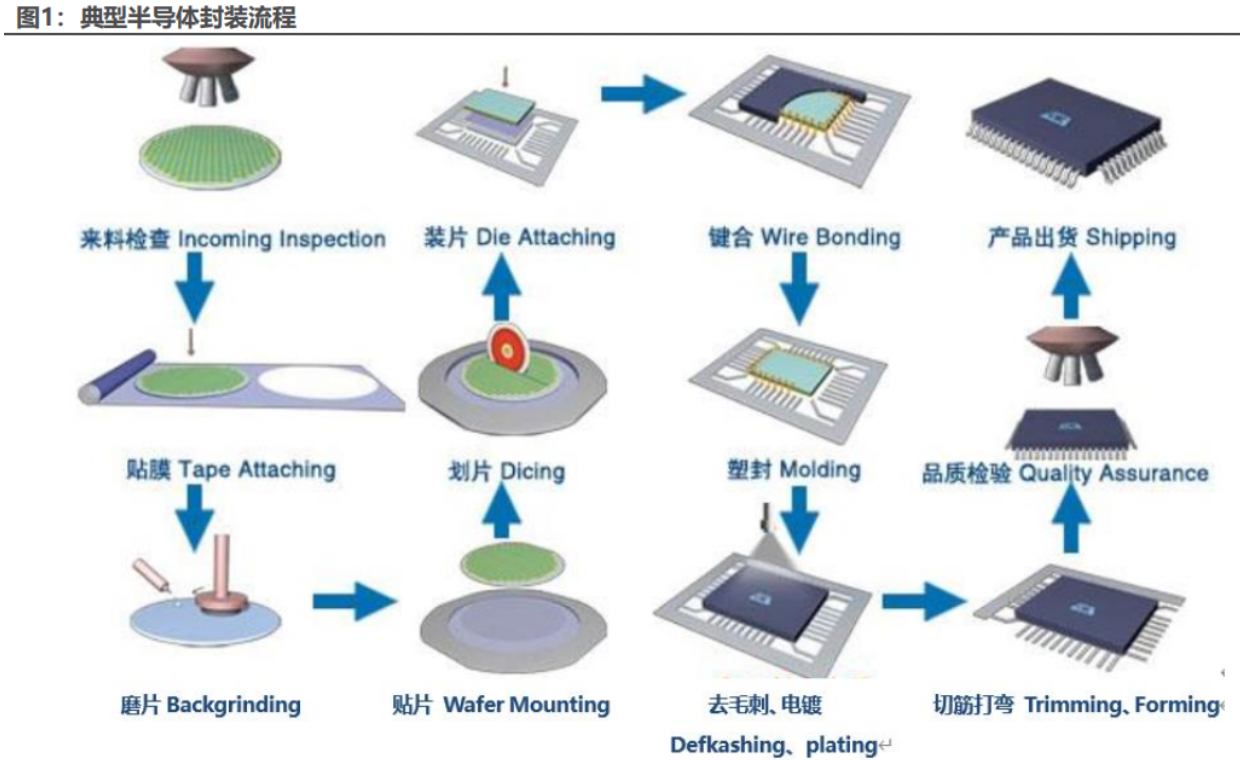
背部研磨
封装厂从晶圆厂那里得到的晶圆还是比较厚的,因为晶圆太薄的话易碎。封装厂需要把晶圆研磨到合适的厚度;

划片、拾取和放置
- 划片:切割得到裸片,通过划片,把一块晶圆切割成数百个芯片裸片,这时候切割出来的芯片会附着在一层胶带上。
- 拾取与放置:逐个移除附着在切割胶带上数百个芯片的过程称为“拾取”。使用柱塞从晶圆上拾取合格芯片并将其放置在封装基板表面的过程称为“放置”。这两项任务合称为“拾取与放置”,均在固晶机(用于芯片键合的装置)上完成。
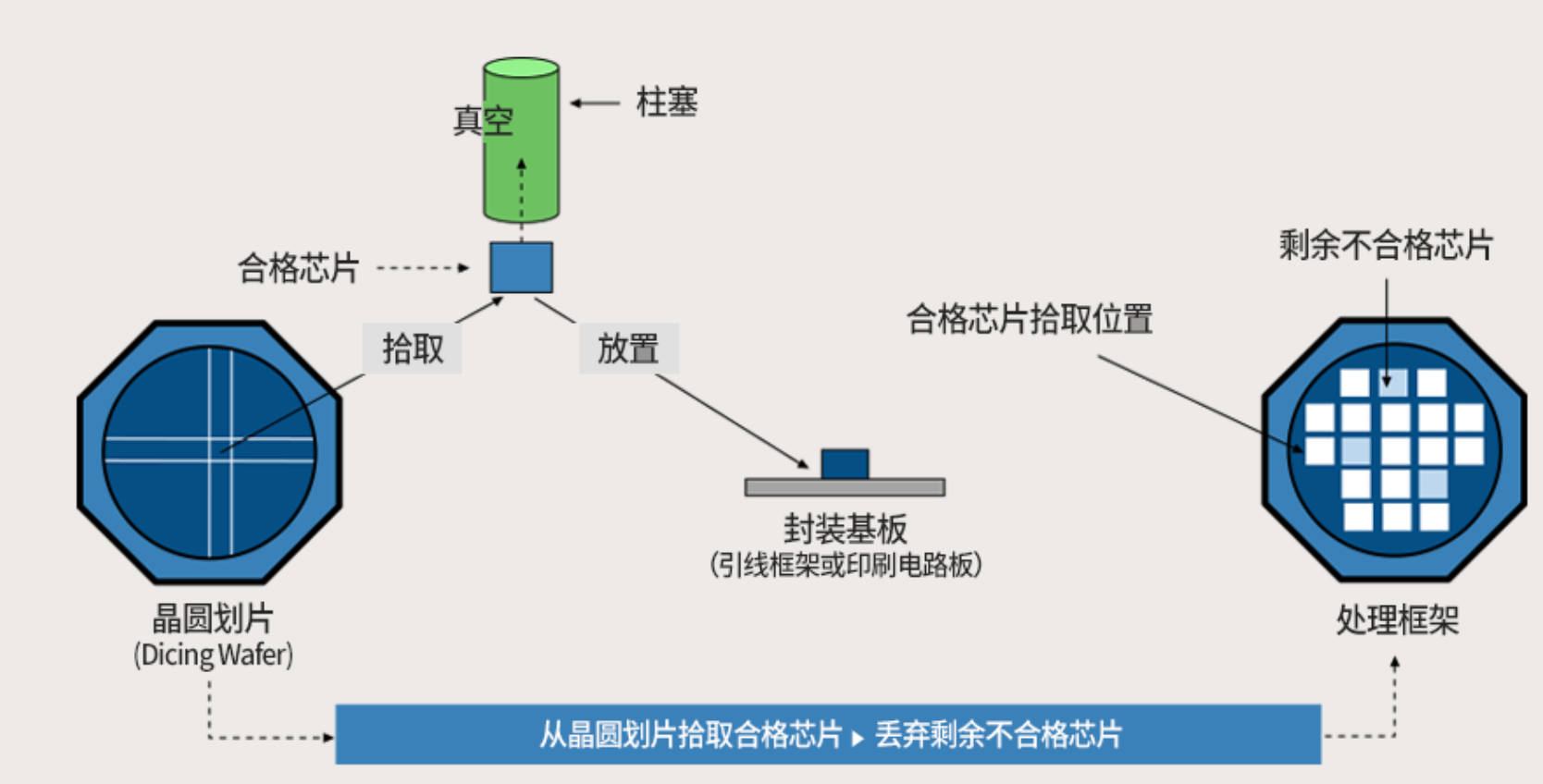
完成划片工艺之后,芯片将被分割成独立模块并轻轻附着在切割胶带(Dicing Tape)上。通过顶出装置(用于从切割胶带下方顶起芯片的顶针)对目标芯片施加物理力,使其与其他芯片形成轻微步差,从而轻松拾取芯片。顶出芯片底部之后,可使用带有柱塞的真空吸拾器从上方拉出芯片。
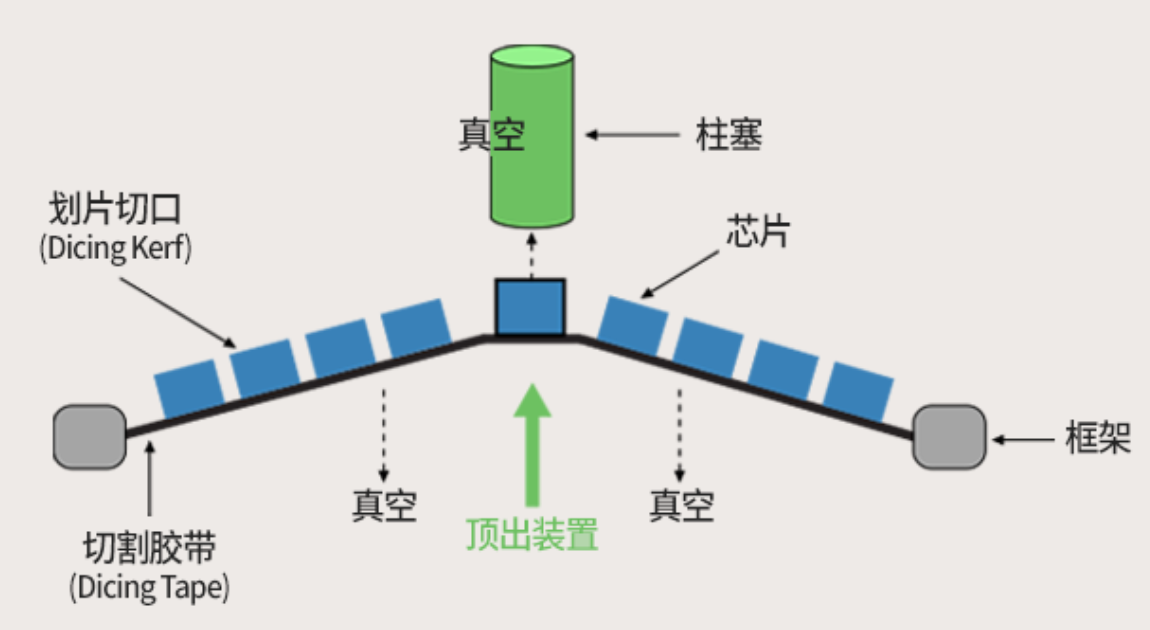
键合
“键合”是指将晶圆芯片固定于基板上。就像发动机用于为汽车提供动力一样,芯片键合技术通过将半导体芯片附着到引线框架(Lead Frame)或印刷电路板(PCB, Printed Circuit Board)上,来实现芯片与外部之间的电连接。
-
传统方法方法步骤
-
首先完成芯片键合(Die Bonding)或芯片贴装(Die Attach)
-
然后引线键合(Wire Bonding)
-
下图为引线框架示意图
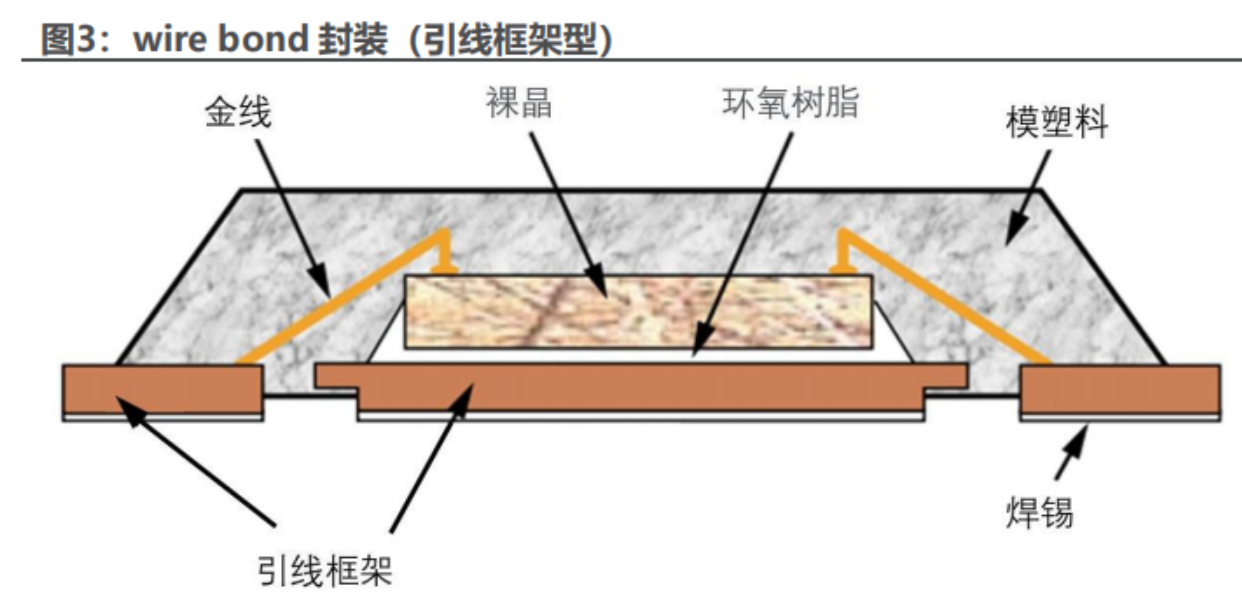
下图为引线键合
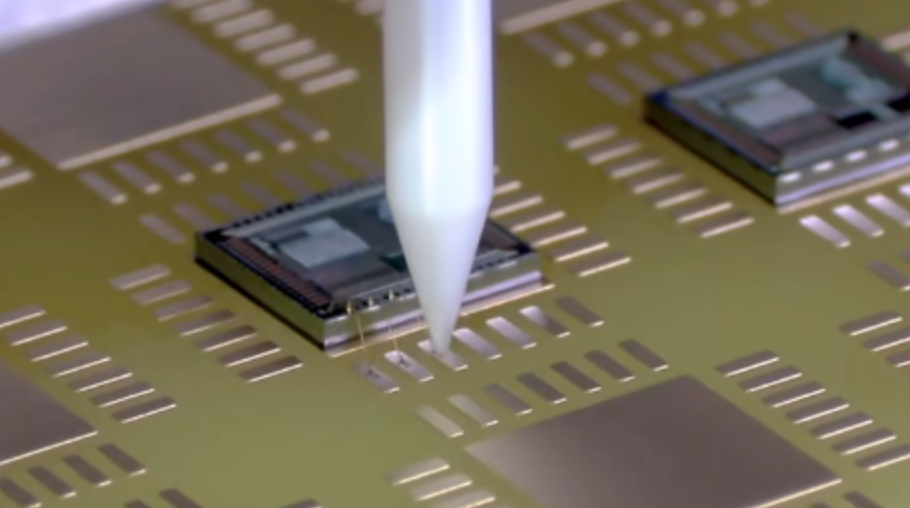
- 先进方法
- 倒装芯片键合(Flip Chip Bonding)(IBM于60年代后期开发)倒装芯片键合技术将芯片键合与引线键合相结合,并通过在芯片焊盘上形成凸块(Bump)的方式将芯片和基板连接起来。
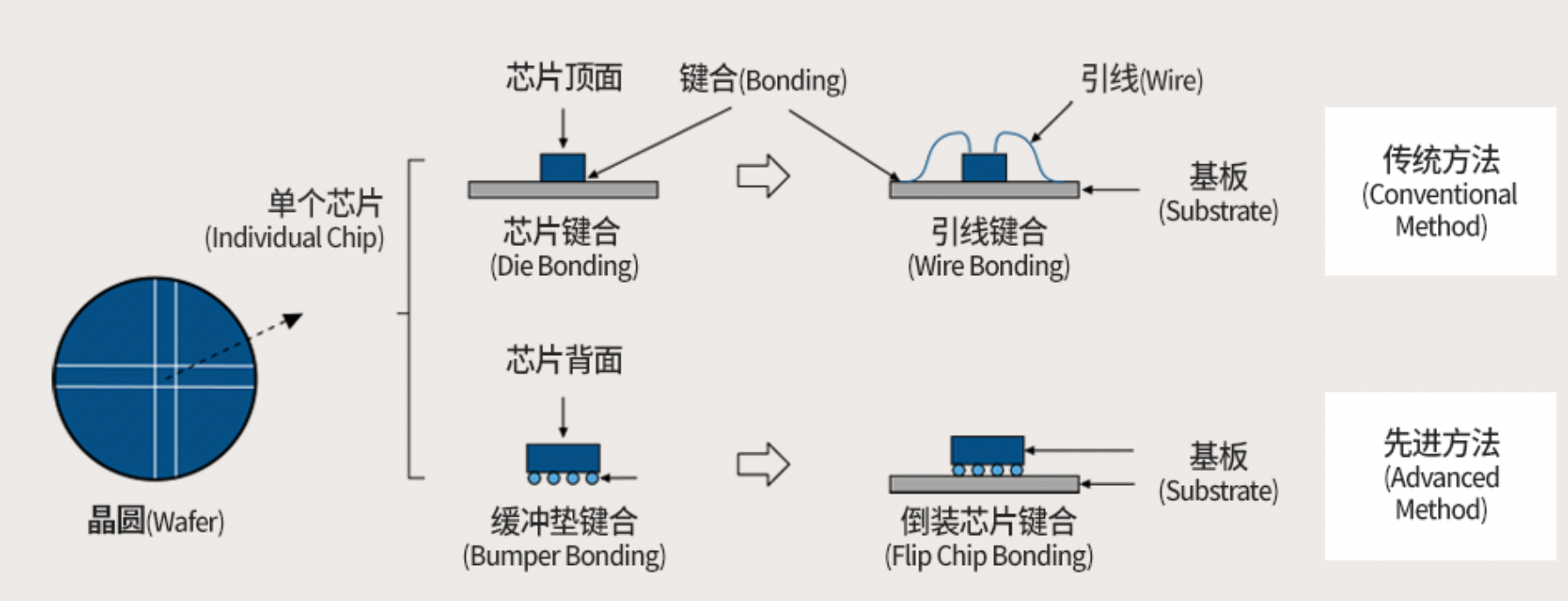
芯片键合步骤图:

塑封
将键合完成的引线框架放在模具中,通过环氧树脂等材料对芯片完成塑封。
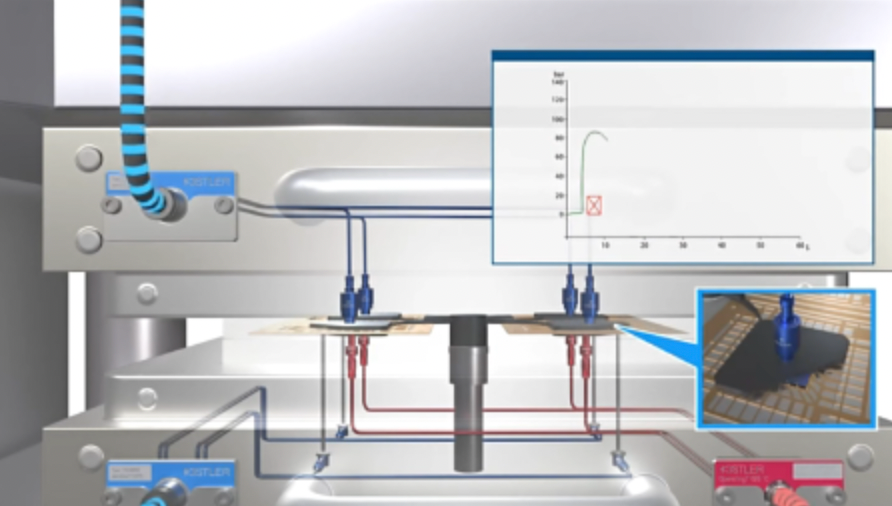
参考文献
[1]华为,Application Defined On-chip Networks for Heterogeneous Chiplets: An Implementation Perspective
[2]华为3D堆叠专利解读,CN201980099842
[3]新思科技,3D Die-to-Die Interconnect Testing Challenges and the Need for an IEEE Standard
[4]新思科技,OpenHBI:小芯片互联的理想接口标准
[5] 西安电子科技大学,田文超团队论文,Using Chiplet Encapsulation Technology to Achieve Processing-in-Memory Functions
[6]CADENCE PCB SOLUTIONS,An Introduction to Die-to-Die Interconnects
[7]《电子工程专辑》2022年7月刊,黄烨锋,这次不说chiplet的好,来谈谈chiplet的“坏”
[8]《电子工程专辑》2022年8月刊,黄烨锋,先进封装的现在和将来,价值链的未来重心
[9]差评君,苹果的新芯片,真就是用两块芯片粘起来的 [10]知乎Vampire,片内互联技术发展概述
[11]Intel,What Are PCIe 4.0 and 5.0?
[12]半导体行业观察,OpenFive发布第八代Die to Die IP,采用Interlaken协议,性能高达1.2Tbps
[13] 并非无解!先进封装技术,能打破国产芯片的困局吗?14nm+14nm=7nm??光刻机被封锁,但是还能另辟蹊径!【深度报告】_哔哩哔哩_bilibili
本文来自互联网用户投稿,该文观点仅代表作者本人,不代表本站立场。本站仅提供信息存储空间服务,不拥有所有权,不承担相关法律责任。 如若内容造成侵权/违法违规/事实不符,请联系我的编程经验分享网邮箱:chenni525@qq.com进行投诉反馈,一经查实,立即删除!
- Python教程
- 深入理解 MySQL 中的 HAVING 关键字和聚合函数
- Qt之QChar编码(1)
- MyBatis入门基础篇
- 用Python脚本实现FFmpeg批量转换
- JavaScript将输入文本在对话框输出
- 一文搞定,JMeter的三种参数化方式
- ICC2:如何用阵列摆放instance
- 服务器宕机怎么办?怎么预防宕机?
- 每日一练【最大连续1的个数 III】
- Java学习系列(五)
- NTFS 磁盘管理 :NTFS Disk by Omi NTFS
- 谈谈你知道的设计模式?请手动实现单例模式 , Spring 等框架中使用了哪些模式?
- C#基础-资源清理-终结器与IDisposable
- 实验02:RIP配置